01SK海力士研发新型晶圆切割技术
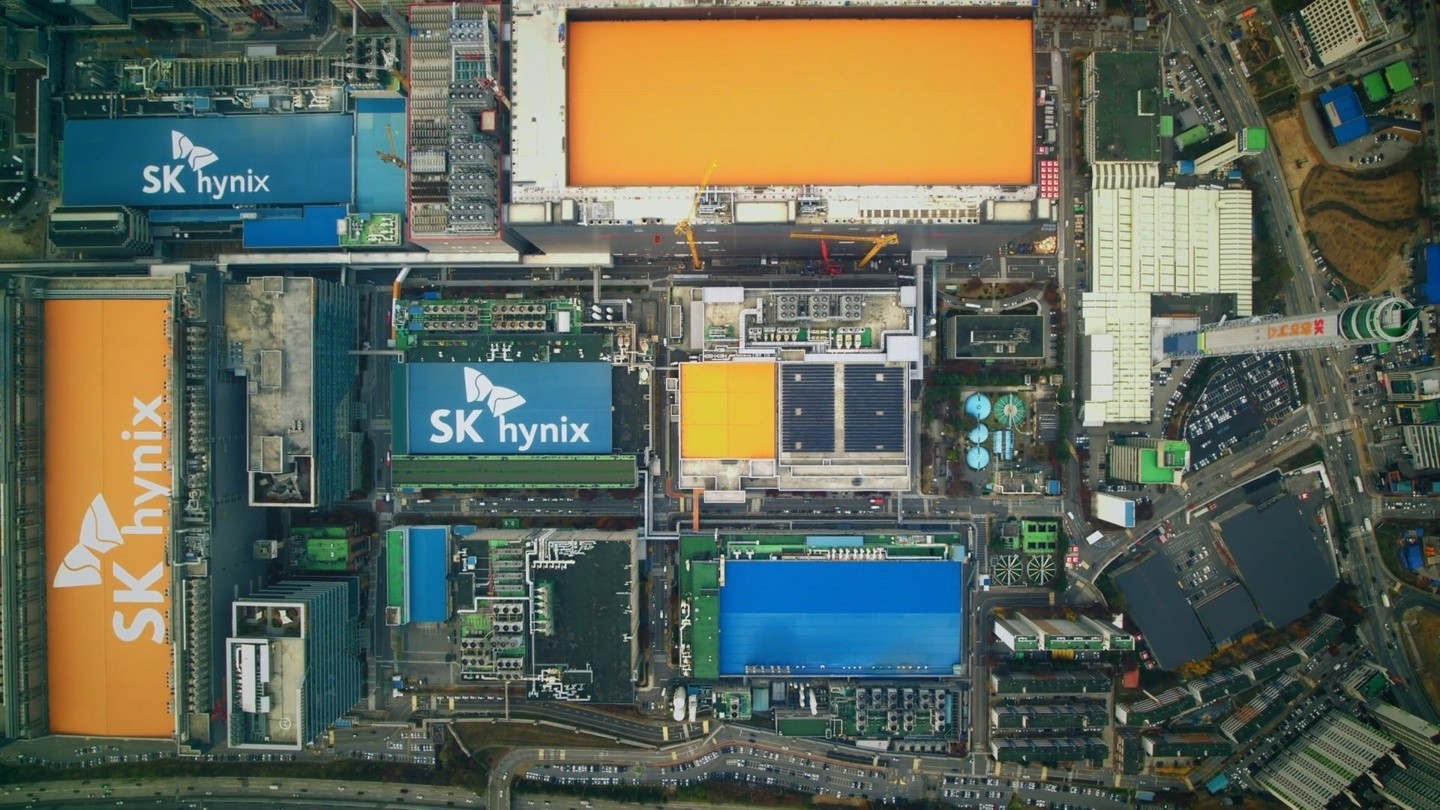
随着存储器晶圆厚度不断减小,SK 海力士正积极研究引入飞秒激光等新型晶圆切割技术,以应对未来技术发展带来的挑战。根据近期报道,该公司已开始与相关激光设备厂商合作,开展联合技术评估项目,并正在测试多种潜在方案,包括预开槽处理和全激光切割方式。
目前,SK 海力士主要采用机械刀片切割(使用金刚石砂轮)和隐形切割(通过内部形成裂隙实现分离)两种方式。然而,这两种方法分别仅适用于厚度在 100μm 以上或约 50μm 的晶圆。
当前先进存储器的晶圆厚度正持续降低,特别是在高带宽存储器(HBM)领域,由于多层堆叠结构对整体高度有严格限制,以及未来层数超过 400 层的 NAND 存储器需要通过混合键合技术将存储单元与外围电路连接,对切割工艺提出了更高要求。为满足这些新型存储产品的制造需求,SK 海力士正积极评估新一代激光切割技术的可行性与实用性。










































































































