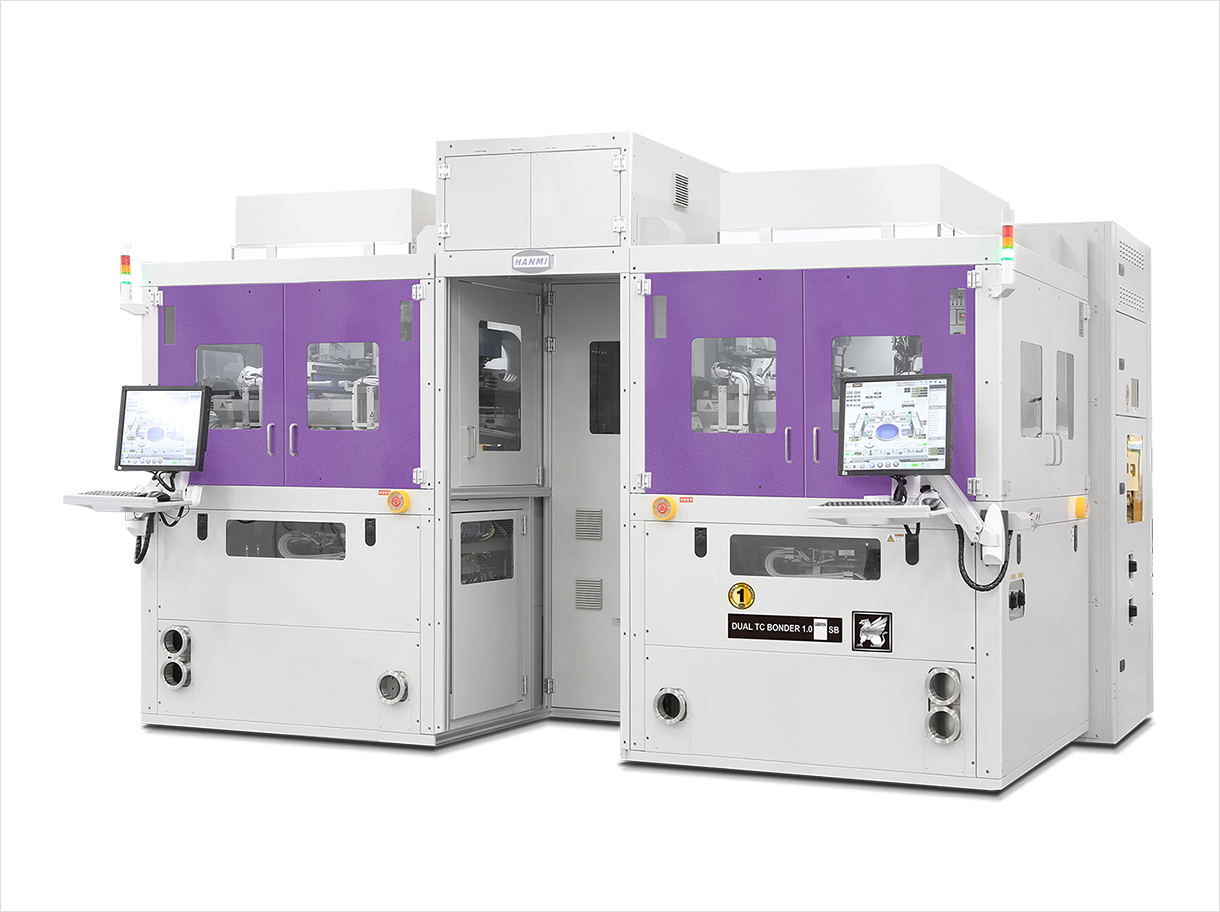
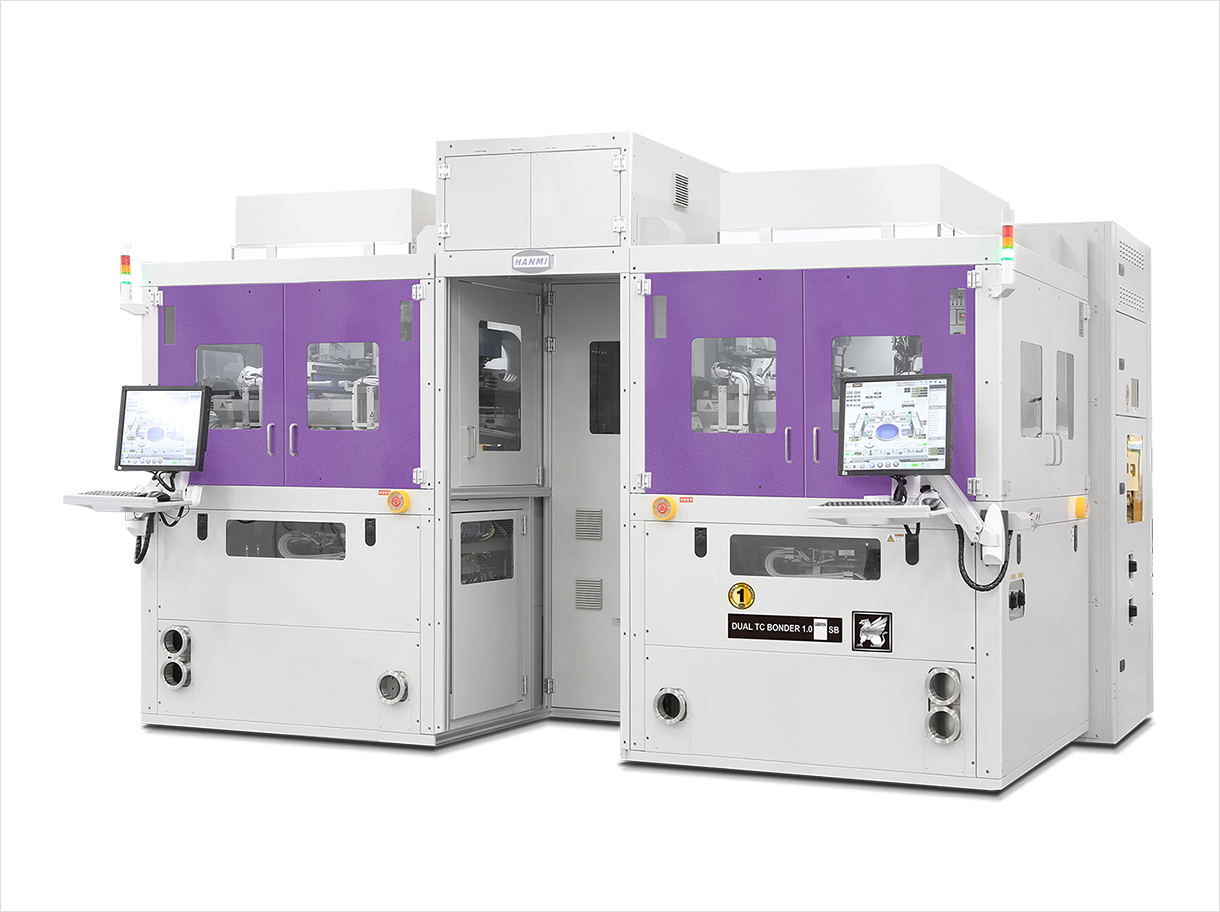
7月16日消息,韩国半导体设备制造商韩美半导体董事长郭东信近日表示,在HBM 4和HBM 5代产品中引入混合键合技术用于HBM内存制造并不必要,相当于过度投入。
韩美半导体是全球领先的HBM内存TC(热压)键合设备供应商。据郭东信介绍,过去两年内,通过该公司设备完成键合工艺的HBM堆叠产品,占据了英伟达HBM3E内存整体供应量的90%。
郭东信指出,混合键合设备的采购成本超过100亿韩元(约合5190万元人民币),是传统TC键合设备的两倍以上。同时,由于JEDEC在HBM4标准中将堆叠高度上限放宽至775微米,采用无凸块结构的混合键合方式在缩小DRAM芯片间距方面已不再成为必须选项,现有的TC键合设备完全能够满足HBM4乃至HBM5的技术要求。
此外,韩美半导体计划在今年推出适用于HBM6需求的无助焊剂型HBM键合设备,而面向更高性能要求的混合键合设备则预计将在2027年面世。
本文属于原创文章,如若转载,请注明来源:韩美半导体董事长:HBM4/5无需混合键合技术https://dcdv.zol.com.cn/1015/10151805.html











































































































